LPCVD低压化学气相沉积设备(科研型LPCVD)是在低压高温的条件下,通过化学反应气相外延的方法在衬底上沉积各种功能薄膜(主要是Si3N4、SiO2及Poly硅薄膜)。可用于科学研究、实践教学、小型器件制造。
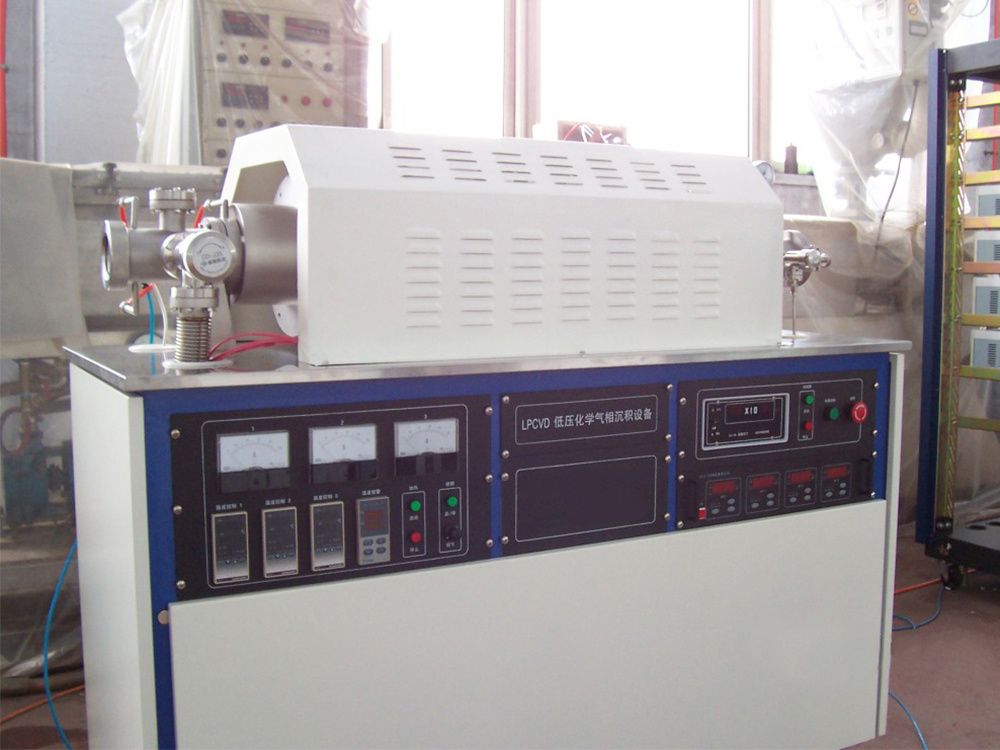
设备结构及特点
1、小型化,方便实验室操作和使用,大幅降低实验成本
两种基片尺寸2英寸或4英寸;每次装片1~3片。
基片放置方式:配置三种基片托架,竖直、水平卧式、带倾角。
基片形状类型:不规则形状的散片、φ2~4英寸标准基片。
2、设备为水平管卧式结构
由石英管反应室、隔热罩炉体柜、电气控制系统、真空系统、气路系统、温控系统、压力控制系统及气瓶柜等系统组成。
反应室由高纯石英制成,耐腐蚀、抗污染、漏率小、适合于高温使用; 设备电控部分采用了先进的检测和控制系统,量值准确,性能稳定、可靠。
3、系统提供自动控制无扬尘装置

LPCVD设备主要技术指标
|
类型 |
参数 |
|
成膜类型 |
Si3N4、Poly-Si、SiO2等 |
|
最高温度 |
1200℃ |
|
恒温区长度 |
根据用户需要配置 |
|
恒温区控温精度 |
≤±0.5℃ |
|
工作压强范围 |
13~1330Pa |
|
膜层不均匀性 |
≤±5% |
|
基片每次装载数量 |
标准基片:1~3片;不规则尺寸散片:若干 |
|
压力控制 |
闭环充气式控制 |
|
装片方式 |
手动进出样品 |
设备功能
该设备是在低压高温的条件下,通过化学反应气相外延的方法在衬底上沉积各种功能薄膜(主要是Si3N4、SiO2及Poly硅薄膜)。
可提供相关镀膜工艺。
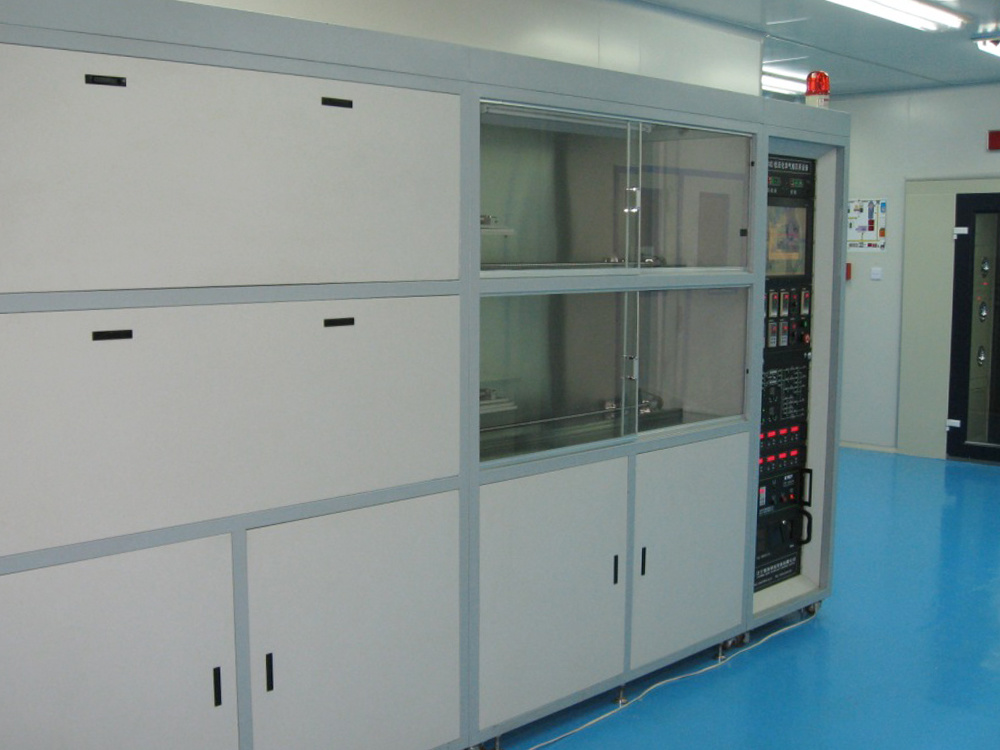
设备结构及特点:
设备为水平管卧式结构,由石英管反应室、隔热罩炉体柜、电气控制系统、真空系统、气路系统、温控系统、压力控制系统及气瓶柜等系统组成。
反应室由高纯石英制成,耐腐蚀、抗污染、漏率小、适合于高温使用; 设备电控部分采用了先进的检测和控制系统,量值准确,性能稳定、可靠。
整个工艺过程由计算机对全部工艺流程进行管理,实现炉温、气体流量、压力、阀门动作、泵的启闭等工艺参数进行监测和自动控制。也可以手动控制。
设备主要技术指标
|
类型 |
参数 |
|
成膜类型 |
Si3N4、Poly-Si、SiO2等 |
|
最高温度 |
1200℃ |
|
恒温区长度 |
根据用户需要配置 |
|
恒温区控温精度 |
≤±0.5℃ |
|
工作压强范围 |
13~1330Pa |
|
膜层不均匀性 |
≤±5% |
|
基片每次装载数量 |
100片 |
|
设备总功率 |
16kW |
|
冷却水用量 |
2m3/h |
|
压力控制 |
闭环充气式控制 |
|
装片方式 |
悬臂舟自动送样 |

LPCVD手动运行界面
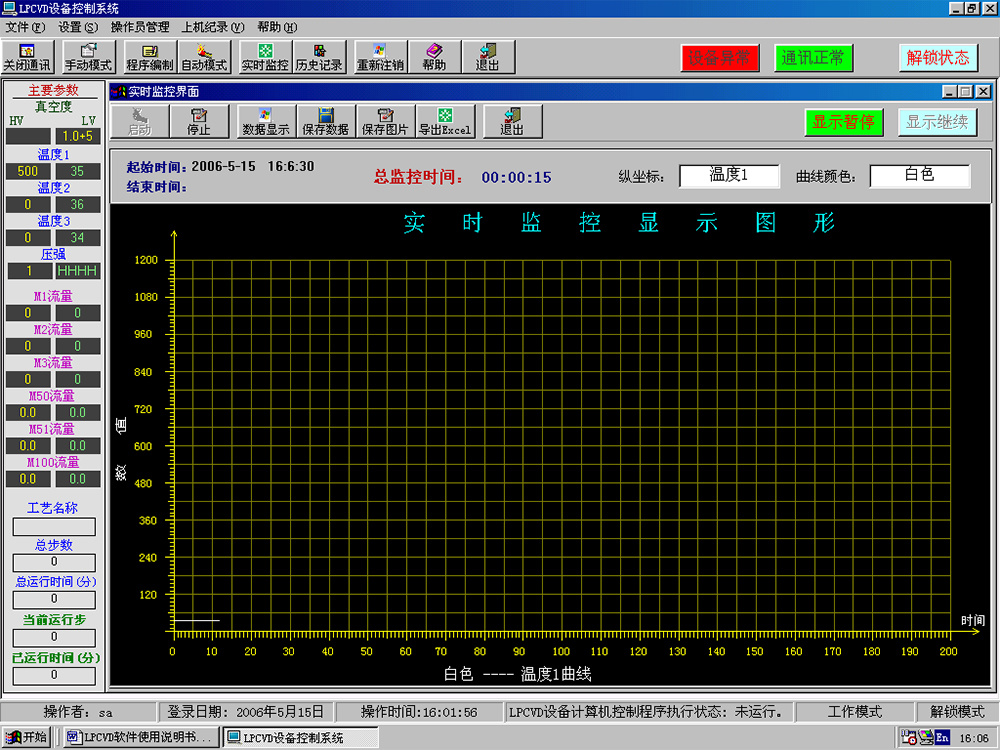
LPCVD实时运行监控界面

LPCVD自动运行界面

LPCVD工艺编制界面





 通过认证
通过认证 


